KDS晶振高興地宣布最新推出的石英晶體定時裝置“Arch.3G”系列正式商業化,實現了通過使用以往不同的結構,產生的壓倒性的輕薄。為了實現小型化,薄型化和高可靠性,該系列采用了與傳統產品不同的新結構,采用導電膠,陶瓷封裝,金屬蓋材料。
在Arch.3G系列中,石英晶體振蕩器和有源晶體振蕩器都實現了世界上最薄的厚度,這個厚度不到傳統結構厚度的一半。在輕薄的前提下,該產品被層壓到硅管芯,如內置到模具中的SIP(系統級封裝)模塊和所述基板,使得有可能提出一個新的值,以有助于節省空間。
采用傳統結構,產品越小,在將石英晶體元件安裝在封裝中時,越難以確保諸如涂層精度和導電粘合劑的安裝位置之類的余量。為了解決這個問題,有必要審查激烈的產品和工藝設計。
這個系列中,精細密封技術是鍵合技術,我們的專有的,由晶體和上級WLP(晶圓級封裝)的三個層的鍵合晶片,常規的結構等效的氣密性被實現了。由保持單元,而無需使用導電性粘接劑的結構允許所述振動部的整體結構,并在同一時間上解決上述步驟的問題,它導致了在耐沖擊性的改善顯著。此外,通過從清洗晶圓清洗到真空環境中的粘接,大大降低了生產的溫補晶振質量風險。我們還將為需要進一步可靠性的汽車應用做出貢獻,包括自動駕駛系統的應用。
而且,由于AT切割晶體器件的石英晶體器件變得高頻薄,因此存在關于貼片晶振工藝質量和生產率的問題。另一方面,在Arch.GGB系列中,采用WLP使生產過程中的處理變得更加容易,并且這些問題得以解決。今后,確定頻率為200MHz,我們會繼續提出這個產品的信息網絡相關的產品,如在數據中心,無線網絡市場,擴大高頻率等市場有高速,大容量的需求。
產品規格

產品尺寸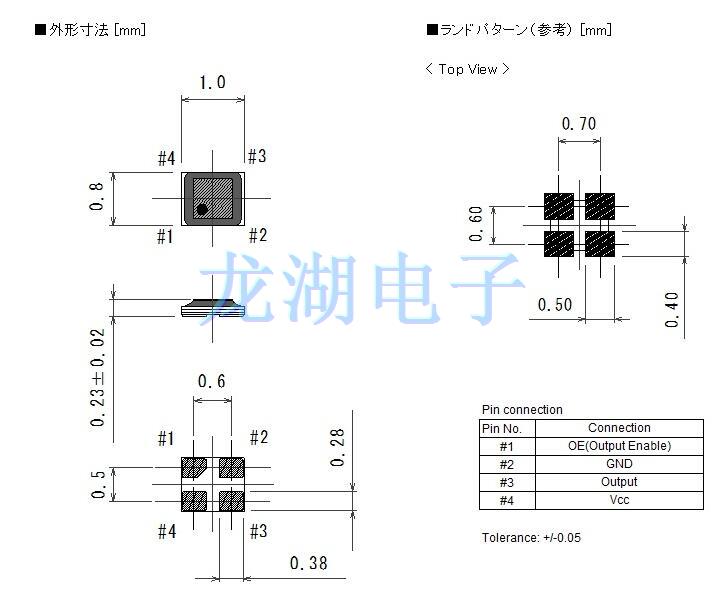
此外,我們可以提供一個新的石英晶體器件安裝場景,如SiP模塊,可以通過實現壓倒性的薄形狀進一步擴展,并內置到IC封裝中提供價值。此外,因此它可以響應包的靈活端子設計,在這種形式的各種外部端子的可能的,例如對應于引線鍵合的產品的形狀。